本文共687字
Ansys(Nasdaq:ANSS)多物理解決方案已通過聯電(2303)認證,可模擬其最新的 3DIC WoW 堆疊技術,從而提高 AI 邊緣運算,圖形處理和無線通訊系統的能力,效率和效能。該認證使更多晶片設計人員能夠使用 Ansys 的半導體模擬解決方案來執行多晶片聯合分析,從而簡化並確保成功的設計。
WoW 技術由垂直堆疊而不是水平放置在板上的矽晶片或晶片組成。Ansys RedHawk-SC 和 Ansys Redhawk-SC Electrothermal 構建在雲優化基礎設施之上,具有快速處理全晶片分析,容量和預測準確性,包括用於電源和信號完整性,熱分析等的多晶片封裝和互連。這些用於多物理分析的 3DIC 解決方案適用於板載和系統電熱分析(包括 Ansys SIwave和 Ansys Icepak)的更全面 Ansys 解決方案。
聯電元件技術開發及設計支援副總經理鄭子銘表示,我們對於與 Ansys 合作提供聯電技術參考流程的成果感到滿意,這使客戶能夠滿足雲端和數據中心應用不斷增長的效能,可靠度和功耗需求。Ansys 綜合晶片封裝聯合分析解決方案與聯電先進的晶片堆疊技術相結合,共同解決了 3DIC 封裝技術中複雜的多物理難題。
Ansys半導體、電子和光學事業部副總裁兼總經理 John Lee 表示,Ansys 和聯電的 3DIC 解決方案解決了複雜的多物理難題,以滿足嚴格的功率,性能,散熱和可靠性要求。Ansys 提供雙向方法從晶片端和系統端設計解決方案相結合,使共同客戶能夠更快的收斂設計問題,並且從晶片級的微小細節到系統級設計挑戰都更具有信心。
※ 歡迎用「轉貼」或「分享」的方式轉傳文章連結;未經授權,請勿複製轉貼文章內容







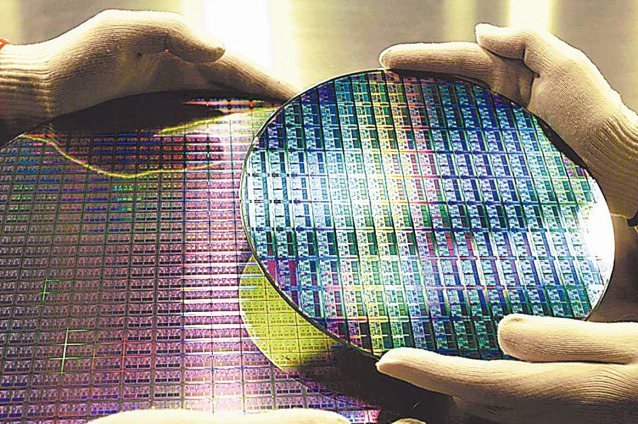

留言