本文共973字
台積電在美西技術論壇中也宣布先進封裝技術大躍進,台積電將在核心的CoWoS技術下,持續引導入客戶導入系統整合晶片 (SoIC),並於2025年完成矽光子(Co-Packaged Optics, CPO)前期的支援小型插拔式連接器的COUPE驗證,再搭配CoWoS封裝成為共同封裝光學元件(Co-Packaged Optics, CPO),將光連結直接導入封裝中,完成AI先進封裝的革命性關鍵技術。
台積電強調,台積電的CoWoS,是讓客戶能夠在單一中介層上並排放置更多的處理器核心及高頻寬記憶體(HBM)。同時,台積公司的系統整合晶片 (SoIC)已成為3D晶片堆疊的領先解決方案,客戶越來越趨向採用CoWoS搭配SoIC及其他元件的做法 ,以實現最終的系統級封裝(Systemin Package, SiP)整合。
台積電強調,公司系統級晶圓(TSMC-SoW)技術提供了一個革新的選項,讓12吋晶圓能夠容納大量的晶粒,提供更多的運算能力,大幅減少資料中心的使用空間,並將每瓦效能提升好幾個數量級。台積電已經量產的首款SoW產品採用以邏輯晶片為主的整合型扇出(InFO)技術,而採用CoWoS技術的晶片堆疊版本預計於2027年準備就緒,能夠整合SoIC、HBM及其他元件,打造一個強大且運算能力媲美資料中心伺服器機架或甚至整台伺服器的晶圓級系統。
其中在矽光子整合更獲得重大突破,台積電表示,公司正在研發緊湊型通用光子引擎(COUPE)技術,以支援AI熱潮帶來的數據傳輸爆炸性成長。 COUPE使用SoIC-X晶片堆疊技術將電子裸晶堆疊在光子裸晶之上,相較於傳統的堆疊方式,能夠為裸晶對裸晶介面提供最低的電阻及更高的能源效率。
台積電預計於2025年完成支援小型插拔式連接器的COUPE驗證,接著於2026年整合CoWoS封裝成為共同封裝光學元件(Co-Packaged Optics, CPO),將光連結直接導入封裝中。
台積電也宣布,將繼2023年推出支援車用客戶及早採用的N3AE製程後, 藉由整合先進晶片與封裝來持續滿足車用客戶對更高運算能力的需求,以符合行車的安全與品質要求。台積電正在研發InFO-oS及CoWoS-R解決方案,支援先進駕駛輔助系統(ADAS)、車輛控制及中控電腦等應用,預計於2025年第4季完成AEC-Q100第二級驗證。
※ 歡迎用「轉貼」或「分享」的方式轉傳文章連結;未經授權,請勿複製轉貼文章內容








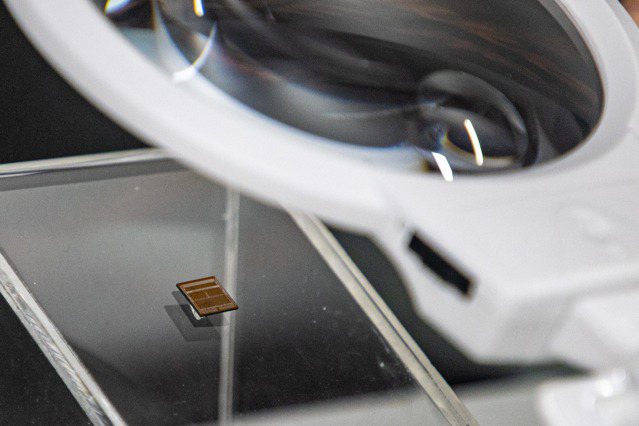
留言