本文共1135字
AI晶片龍頭輝達(NVIDIA)最快2026年導入面板級扇出型封裝,藉此緩解CoWoS先進封裝產能吃緊,導致AI晶片供應不足的問題,打破當下CoWoS在AI先進封裝獨霸局面。
台灣封測廠中,力成(6239)布局面板級扇出型封裝腳步最快,已有國際IC設計大廠上門談合作,公司樂見輝達引領面板級扇出型封裝時代來臨,全力迎接商機。
業界看好,隨著輝達登高一呼,面板級扇出型封裝時代將為台灣封測業帶來更多接單契機。伴隨英特爾、超微(AMD)等半導體巨擘也積極揮軍面板級扇出型封裝,後續AI晶片供應更順暢,也將引領AI發展更加百花齊放。
業界人士指出,以玻璃作為封裝基板,堪稱晶片發展的「下一個重大趨勢」(the next big thing)。預期隨著AI數據處理數量激增,傳統塑膠材質基板已難以擔負重任,玻璃基板時代來臨,最初將用於AI加速器和伺服器CPU等高階產品,並逐漸擴大使用。
業界傳出,輝達最快2026年將導入面板級扇出型封裝,英特爾、超微等半導體巨擘之後也將加入。伴隨AI趨勢成長顯著明確,各指標廠也瞄準該領域,包括微軟、亞馬遜陸續推出自研AI晶片, 面對強而有力的AI需求,先進封裝產能不足的狀態,讓同樣是先進封裝的面板級扇出型封裝,成為紓解AI晶片供應的利器。
業界說明,扇出型封裝有兩個分支,分別為晶圓級扇出型(FOWLP)及面板級扇出型(FOPLP),由於面板級扇出型封裝不用傳統載板材料,讓封裝成本降低、厚度變薄,晶片產品更吸引人,力成在2018年就喊出面板級扇出型封裝將改變未來封裝產業。
目前台灣封測廠當中,力成布局面板級扇出型封裝腳步最快,該公司為搶進高階邏輯晶片封裝,已透過旗下竹科三廠全面鎖定面板級扇出型封裝和TSV CIS (CMOS影像感測器)等技術,強調透過扇出型封裝,可進行異質整合IC。
力成正向看待面板級扇出型封裝時代帶來的商機。力成分析,與晶圓級扇出型封裝相較,面板級扇出型封裝產出的晶片面積多了二至三倍。
業界透露,力成深耕面板級扇出型封裝許久,已陸續有國際IC設計客戶上門談合作,站在絕佳的戰鬥位置,以扎實的技術和製程,迎接面板級扇出型封裝大放異彩的時刻。
閱讀秘書/面板級扇出型封裝
面板級扇出型封裝(FOPLP)以玻璃取代傳統塑膠材料當作基板,具備多項優勢,包括可容納更多的I/O數、效能更強大、節省電力消耗等。
面板級扇出型封裝透過使用多層內導線結構,將數個晶片整合到封裝體中,實現高密度封裝製程,達到產品高效能且體積小的要求。
面板級扇出型封裝產出的晶片元件具備較佳的導電性、電性功能及散熱性,加上因採用方形的玻璃作為基板,較晶圓的圓形有更高的利用率、達95%,有助降低成本。 (李孟珊)
延伸閱讀
※ 歡迎用「轉貼」或「分享」的方式轉傳文章連結;未經授權,請勿複製轉貼文章內容










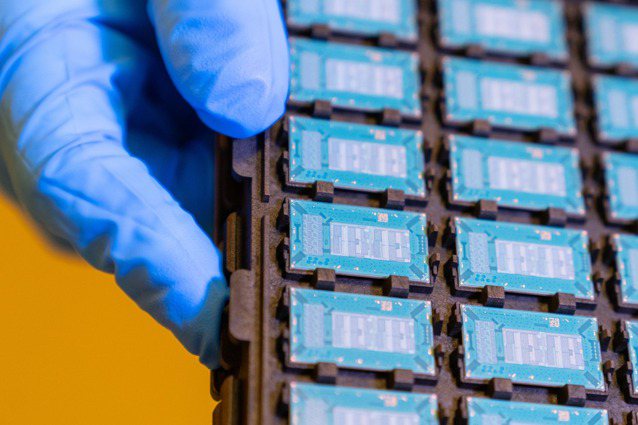

留言